加工事例Laser Processing Examples
Si基板へのスクライブ(溝)加工
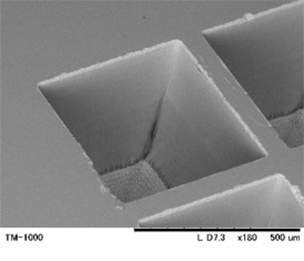
- 材料:
- Si基板
- 寸法:
- 630µm厚
- 加工:
- スクライブ(溝加工)
- 形状:
- □500µmエリア / 深さ 300µm / 隔壁間隔 100µm
- 速度:
- <29秒/穴
周囲に熱影響が無く、断面状態、エッジ状態ともに良好で、均一な深さに指定形状を掘ることができます。
表面から少しずつ削り取るように、深さを確保して行きますので、深さ精度もサブミクロンでコントロールできます。
対象材料によっては、1µm以下の分解能でアブレーションを行うことも可能です。
